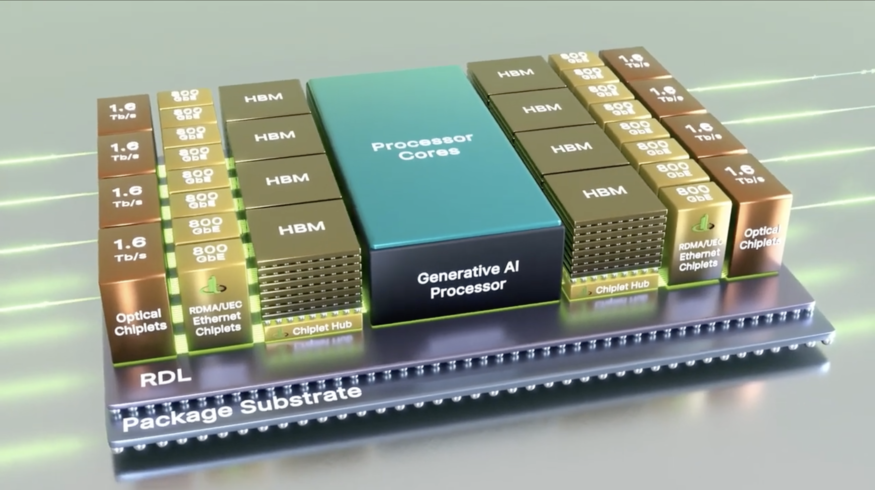
[더구루=정예린 기자] 삼성전자가 지난해 투자한 미국 칩렛 플랫폼 개발 회사 '드림빅 세미컨덕터(이하 드림빅)'와의 협력을 본격화한다. 자사 4나노미터(nm) 파운드리(반도체 위탁생산) 공정에 드림빅의 최신 설계 플랫폼을 통합, '게임체인저'라고 불리는 '3D 고대역폭메모리(HBM)'를 포함한 차세대 기술을 구현한다.
드림빅은 6일(현지시간) 삼성전자 파운드리 4나노 공정(SF4X) 핀펫(FinFET) 구조에 '마스 칩렛 플랫폼(MARS Chiplet Platform, 이하 마스 플랫폼)'을 최적화했다고 발표했다. 삼성 파운드리 고객들은 드림빅의 플랫폼을 활용해 인공지능(AI), 데이터센터 등 고성능 컴퓨팅용 칩을 만들 수 있다.
마스 플랫폼은 드림빅이 작년 1월 공개한 칩렛 기반 설계 플랫폼이다. 다양한 기능을 가진 독립적인 반도체 다이인 칩렛을 모듈화해 사용자가 원하는 고성능 시스템을 설계하고 구성할 수 있게 해준다. 칩렛을 설계하는 데 필요한 소프트웨어, 기술, 하드웨어 모듈을 제공하는 종합 플랫폼인 셈이다.
가장 눈에 띄는 특징은 3D HBM과 통합됐다는 것이다. 3D HBM은 그래픽처리장치(GPU) 옆으로 HBM을 연결하는 2.5D 구조와 달리 위로 적층하는 방식이다. GPU와 HBM 간 거리가 가까워지고 작은 공간에 더 많은 메모리를 구현할 수 있어 용량을 확장하면서도 전력 소모를 줄이고 대역폭을 극대화할 수 있다.
삼성 4나노 공정 파운드리 고객들은 삼성전자와 드림빅 간 이번 협력을 통해 3D HBM 방식의 칩을 설계할 수 있게 됐다. 3D HBM이 AI 훈련과 추론 등 메모리와 성능이 중요한 작업을 처리하는 데 적합한 만큼 마스 플랫폼을 통한 설계 방식이 각광받을 것으로 예상된다.
마스 플랫폼은 삼성전자의 3D 칩온웨이퍼(CoW) 패키징 기술도 지원한다. 삼성 파운드리 고객이 4나노 공정에서 마스 플랫폼으로 설계한 칩을 만들고, 삼성의 3D 칩온웨이퍼 기술을 활용해 패키징까지 하는 통합 생태계가 구축된 것이다.
이밖에 마스 플랫폼은 드림빅의 '칩렛 허브'를 통해 AI 프로세서, 네트워킹 IO 등 여러 개의 칩렛을 효율적으로 결합해 하나의 고성능 시스템을 만든다. PCIe 등 고속 인터페이스를 활용해 칩렛 간 연결한다. UCIe 등 규격을 지원, 다양한 칩렛을 조합할 수 있다.
삼성전자와 드림빅은 작년 7월 삼성전자 산하 삼성카탈리스트펀드가 드림빅의 7500만 달러 규모 시리즈B 펀딩 라운드에 참여하며 인연을 맺었다. 삼성전자는 투자를 단행한지 약 6개월 만에 드림빅과의 파트너십을 구체화하며 동맹을 강화하고 있다.
노미정 DS부문 미주법인(DSA) 담당임원(상무)은 "차세대 AI 애플리케이션과 칩렛 기반 시스템 설계가 융합되고 있으며, 드림빅의 마스플랫폼은 3D HBM 통합을 통해 칩렛 기반 AI 솔루션을 제공할 수 있는 좋은 위치에 있다"며 "칩렛 기반 아키텍처를 위한 다양한 설계 지원과 함께 드림빅과 SF4X 공정 기술에 대한 파트너십을 맺게 되어 기쁘다"라고 밝혔다.
소하일 시예드 드림빅 최고경영자(CEO)는 "삼성 파운드리 SF4X 공정과 3D 제조의 고급 기능으로 구현된 칩렛 허브의 기본 다이는 3D HBM 통합에 필요한 저전력을 달성하는 동시에 최고의 성능과 지연 시간을 제공한다"며 "마스 플랫폼은 비교할 수 없는 확장 및 확장 솔루션을 제공, 고객이 최저 비용과 가장 빠른 출시 기간으로 최고 수준의 성능과 에너지 효율성을 달성할 수 있게 한다"고 전했다.


























