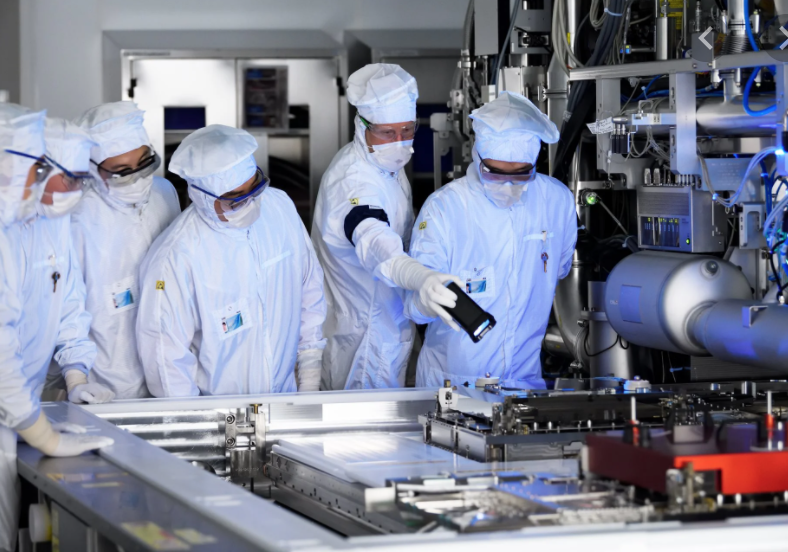
[더구루=정예린 기자] 네덜란드 반도체 장비 기업 ASML이 극자외선(EUV) 펠리클 개발을 완료했다. 웨이퍼 불량을 줄여 7nm(나노미터) 이하 초미세 공정의 수율을 높일 수 있을 것으로 기대된다.
24일 업계에 따르면 ASML은 최근 EUV 펠리클 개발에 성공하고 대량 양산에 박차를 가하고 있다.
EUV 펠리클은 반도체 핵심 공정인 EUV 포토리소그래피(노광) 공정 중 오염을 방지하는데 사용된다. 포토리소그래피 공정은 회로 모양이 그려진 포토마스크에 빛을 쬐여 실리콘 웨이퍼에 패턴을 새기는 작업이다. 포토마스크가 오염되면 불량률이 증가하는데 일종의 얇은 덮개인 펠리클은 포토마스크 오염을 막고 수명을 연장하는 역할을 한다.
특히 기존 불화아르곤(ArF) 공정과 달리 EUV 공정은 기존과 똑같은 오염 물질이 발견되더라도 상대적으로 더 큰 문제를 야기해 EUV 펠리클은 핵심 요소로 여겨져 왔다.
EUV 펠리클을 이용하면 수율뿐 아니라 생산 비용도 줄일 수 있다. EUV 공정에 사용되는 포토마스크는 수억원대에 달해 오염되면 교체하는데 비용 부담이 크기 때문이다.
EUV 공정은 ArF 공정과 달리 광원을 반사하는 방식을 택해 포토마스크의 특성이 바뀌면서 기술 난이도가 높은 새로운 펠리클을 개발해야 했다. 업계에서는 기술적 난관에도 불구하고 EUV 펠리클을 확보하기 위해 치열한 경쟁을 펼쳐왔다.
국내에서는 ArF용 펠리크 제작 노하우를 가진 에프에스티와 삼성전자의 투자를 등에 업은 에스앤에스텍 등이 EUV 펠리클 개발에 박차를 가하고 있다.


























